RDA 光刻胶显影分析仪 (Photoresist Development Analysis Instrument)
测量及分析光刻胶排气 (PR Outgas Measusing & Analysis)
PAGA-100 光至产酸剂去保护团反应分析仪 (PAGA-100 PAG Deprotection Reaction Analyzer)
树脂品质检定 (Resin Quality Inspection)
3合1 涂布/烘烤/显影 光刻胶小型实驗室 (3 in 1 Spincoat/Baking/Developing Robot unit. for Photorestist R&D)
现时有用于g光线(436nm)和i光线(365nm)的光刻胶用树脂,也有线型酚酫树脂(NOVOLAK)、KrF光线(248nm)光刻胶用树脂及PHS树脂等等。这些都是可以用碱性显像液来溶解的。因此,这些树脂生产商多数以它们在碱性显像液中的溶解速度来作为质量管理的指针。所以,我们在这里讲述如何测定这些制造光刻胶的糊状树脂在碱性显像液中的溶解速度及如何进行它的质量管理。
10.1.1 评估装置及评估方法的概要
在使用光刻胶显像分析仪(Resist Development Analyzer)的时候,我们是可以调校树脂在碱性显像液中的溶解性的。以下的圖10-1就是樹脂顯像速度監控儀的简易版。
 图 10-1 : 树脂分析仪(简易版)外观
图 10-1 : 树脂分析仪(简易版)外观
在进行显像中的光刻胶薄膜被单色光所照射,由树脂膜表面和基板表面都会有光的反射,这便产生干涉。膜厚在減少中,而根據薄膜的干涉原理,這些干涉或強或弱,成為一個正弦波,並且反覆形成一個信號,這就是一個λ/4n的周期,最后全融化后得到這個由基板表面上產生的反射的數值,稱為BTT時間,另外,這目前所形成的一個干涉波形的極小點稱為控制時間點CPT都可以被檢出,成為一個顯像管理值。由BTT时间及CPT点这两方面,便可以轻易地检出这个极小点管理值,并且精确度高。
 图 10-3 : 显像时发生的干涉波形(这例子是PHS树脂,膜厚2.6um,监察的波长是950nm
图 10-3 : 显像时发生的干涉波形(这例子是PHS树脂,膜厚2.6um,监察的波长是950nm
数据显示是PHS树脂的质量管理。对应CPT(控制点时间)用30秒为基准值,所以这个例子是将管理值设定为28至32秒。从这例子可以见到随着批次的变更,CPT值有所增加。就是这样,便可以在出货时利用CPT值来将溶解速度是相同的树脂才予以出货。
前述10.1已讲解了树脂溶解速度的管理装置及它的方法。现在是讲解这些含有感光剂的感光性树脂的质量管理。关于它的质量管理,有所谓感光速度。所谓感光速度,是当按照规定的膜厚予以涂布来进行曝光,并在所规定的时间内予以显像时,得出该涂膜可以成功曝光的最少曝光量(Eth)。
一般测定这个数值的步骤下:
(1) 将这些光刻胶进行曝光(使用阶段式变化曝光量来予以曝光)
(2) 在规定的显像时间内予以显像。
(3) 用膜厚计来测定曝光完成时所留下来的膜厚,并通过计算来求得这个涂
膜可以成功曝光的曝光量。在用来测定感光速度的曝光装置、显像装置、测定膜厚装置这三个方面,日本LTJ公司都有提供的。这样,对感光性树脂的感光速度方面的管理便成为可能了。
(1) 使用UVES-2500做阶段式变化曝光量的曝光
图10-5是这个阶段式变化曝光量曝光装置的外观照片。再者,在图10-6也显示了线外对位装置(英文是OFF LINE ALIGNMENT)的照片。使用一个盛载匣将WAFER运送到这个对位装置来做对位,然后送到去曝光这一段。同時,通過更換濾光片,便可以自由選用248、365、405、436nm波長的光,乃至於選用寬頻光BROADBAND。(图10-7)。
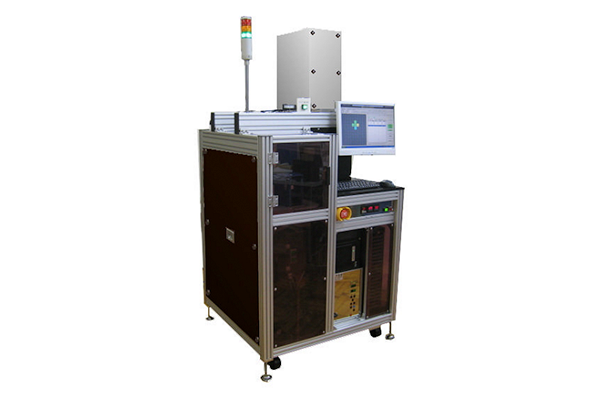 图 10-5 : UVES-2500
图 10-5 : UVES-2500
说到曝光这个步骤,首先,要测定基板上的照射能量,然后根据既定的程序,进行阶段曝光。这个时候,曝光量是使用In-situ监察的,通常是使用既定的光量来进行曝光的,曝光时间也是自动控制的了。图10-8是显示了曝光这阶段时的情况,图10-9则是在曝光中时计算机上的画面。
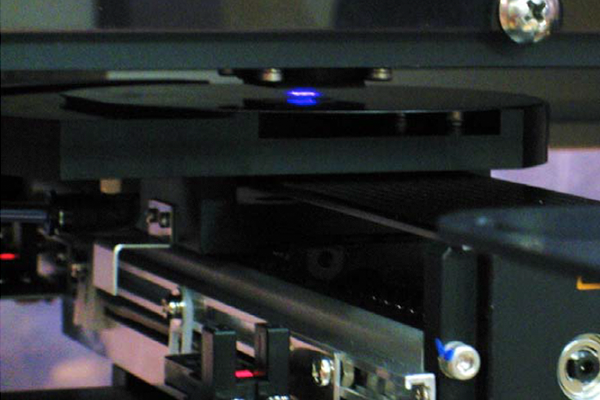 图 10-8 : 曝光阶段时的情况
图 10-8 : 曝光阶段时的情况
在曝光完了的时候,WAFER会被机械臂送回到盛载匣原来的位置中。
(2) 使用SD-200装置做显像
順次,我們可以用SD-200來做這個顯像。图10-10便是这个SD-200的外观照片。圖10-11則是用照片顯示了當進行顯像時,顯像杯的情況。显像液是被控制在23℃ ± 0.1℃ 的范围内,在这情况下,可以实现高精度的显像。
 圖 10-10 : 品質管理用的顯像裝置SD-200
圖 10-10 : 品質管理用的顯像裝置SD-200
(3) 使用膜厚计来测定剩余膜厚的厚度和感光剂量(Eth)
显像完成后的WAFER的照片如下图10-12所示。根据曝光量,得到的膜厚减少情况如下所示。
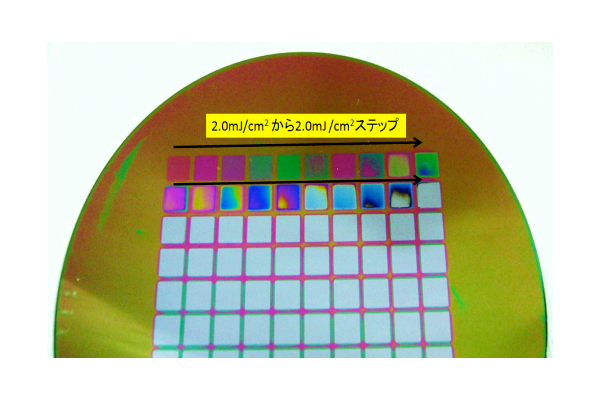
图10-12 已显像后的WAFER(使用阶段式变化曝光量,由2.0mj/cm2的剂量开始)
如图10-13所示,根据剩余膜厚的测定结果,我们获得了感光速度曲线和感光剂量(Eth)的计算结果。
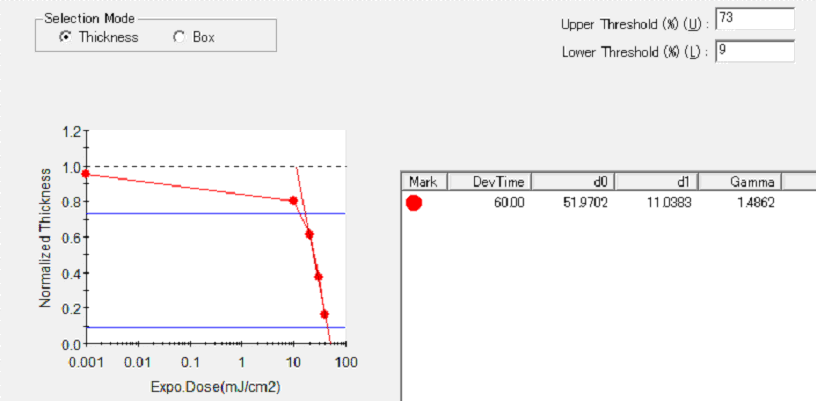
图 10-13 : 感光速度曲线和感光剂量的计算例子
所以,使用本公司这套系统,便能够在不需要花大笔钱去使用stepper/scanner的情况下,实现了对感光性树脂的感光方面的各项评估。